Por qué necesita nuestros servicios, sabe que está obteniendo profesionales altamente calificados que tienen la experiencia y los conocimientos para asegurarse de que su proyecto se realice correctamente y funcione.

Los diodos y transistores con canales de AlN ofrecen altos voltajes de ruptura y funcionan a temperaturas increíblemente altas.
VARIAS actividades humanas se están expandiendo a entornos extremos, a menudo motivadas por la explotación de recursos. Esto ha llevado a la exploración en diversas direcciones, incluso en las profundidades subterráneas, a grandes profundidades en el mar y en el espacio profundo. En todos estos entornos la temperatura es extrema: supera los 300 °C en la superficie de Venus, en la perforación de pozos profundos y en el espacio dentro de un motor en funcionamiento.
Para saber más sobre todos estos entornos se requiere el despliegue de sensores. Pero los más obvios, es decir, los basados en silicio, no están a la altura debido a un límite de temperatura de funcionamiento relativamente bajo. Esto significa que para enriquecer nuestras vidas en estos entornos, necesitamos desarrollar electrónica de temperaturas extremas.
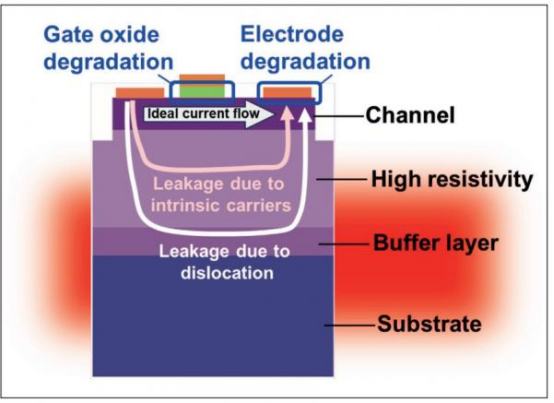
Figura 1. La ruta de la corriente de fuga y los puntos de degradación térmica en un MESFET con un óxido de puerta.
Cuando todos los tipos de dispositivos semiconductores funcionan a temperaturas extremas, se enfrentan a problemas asociados con los materiales, los electrodos, los óxidos de puerta y el embalaje (consulte la Figura 1). A medida que aumenta la temperatura, se generan numerosos pares electrón-hueco, debido a la excitación de los electrones desde el máximo de la banda de valencia hasta el mínimo de la banda de conducción. Estos electrones, que aumentan la concentración de portadores intrínsecos (ver Figura 2 (a)), son perjudiciales, ya que aumentan la corriente de fuga de los dispositivos e impiden que se apaguen. Las opciones para reducir la corriente de fuga incluyen la introducción de materiales semiconductores con una energía de banda prohibida más grande y concentraciones de portadores intrínsecos más bajas (consulte la Figura 2 (b)), o restringir la difusión de corriente desde áreas distintas al canal. Pasar a una capa de canal rodeada de capas de alta resistividad que tienen bajas concentraciones efectivas de donante/aceptor y bajas concentraciones de defectos puede elevar la temperatura de funcionamiento del dispositivo. Otro enfoque consiste en implementar dispositivos con uniones p-n, como JFET y BJT. En estos casos, también es importante seleccionar metales refractarios para los electrodos que tengan una reactividad mínima con los semiconductores base. En particular, el titanio, el vanadio, el tantalio, el molibdeno, el tungsteno y el platino son mejores para este fin que el aluminio, el magnesio, el cobre, la plata, el indio y el oro.
¿Por qué utilizar AlN?
Hay muchos materiales semiconductores con una energía de banda prohibida mayor que la del silicio. Incluyen SiC (3,3 eV), GaN (3,4 eV), Ga2O3 (4,7-5,2 eV), diamante (5,5 eV) y AlN (6,1 eV). El equipo de la NASA, dirigido por Philip Neudeck, informó que los JFET de SiC pueden funcionar a temperaturas superiores a 800 °C. Si bien este es sin duda un resultado impresionante, los materiales con bandas prohibidas aún más amplias prometen alcanzar temperaturas aún más altas. Sin embargo, muchos de ellos tienen importantes inconvenientes. GaN sufre de una alta concentración de donante efectivo de 1016 centímetro-3; no es posible formar Ga tipo p2O3 capas; y el diamante comienza a reaccionar con el oxígeno alrededor de los 700 °C. En marcado contraste, el AlN no tiene defectos obvios y ofrece estabilidad térmica y dopaje controlable. Debido a estos atributos, nuestro equipo de la Universidad de Tsukuba ha estado dedicando toda nuestra atención al AlN para el desarrollo de dispositivos de temperaturas extremas.
Históricamente, se ha asumido que el AlN sólo sirve como aislante. Sin embargo, hace unos 20 años, Yoshitaka Taniyasu y sus colegas de NTT demostraron que este no es el caso mediante el crecimiento de capas de AlN eléctricamente conductoras mediante MOCVD.
Este equipo registró una movilidad de electrones de 426 cm.2 V-1 s-1 para capas de AlN dopadas con silicio, para una concentración de dopante de 3 x 1017 centímetro-3. Sobre la base de este trabajo, fueron pioneros en el crecimiento de AlN de tipo p y demostraron los primeros LED de AlN con una longitud de onda de 210 nm y diodos p-n de AlN cuasi verticales. Estos éxitos se deben al reciente y rápido desarrollo de LED de luz ultravioleta profunda basados en AlGaN y AlN.
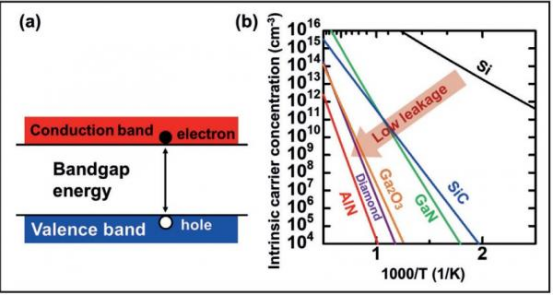
Figura 2. (a) Una ilustración de la generación de pares electrón-hueco a altas temperaturas. (b) La concentración de portador intrínseco de silicio, SiC, GaN, diamante β-Ga2O3 y AlN en función de la temperatura recíproca.
Además de los dispositivos ópticos, la comunidad investigadora ha investigado los diodos de barrera Schottky de AlN y los HEMT de AlN/AlGaN para explorar los beneficios potenciales de un campo eléctrico altamente crítico. Desafortunadamente, estos dispositivos adolecen de una baja concentración de portadores, debido a las altas energías de ionización de los donantes y aceptores: es de 0,3 eV para el silicio y 0,6 eV para el magnesio. Debido a esto, las concentraciones de portadores de ambos dopantes son alrededor de dos órdenes de magnitud más bajas que sus concentraciones, lo que hace que los dispositivos tengan corrientes muy pequeñas. Para superar este problema, nuestro equipo, en colaboración con investigadores del MIT y la Universidad Aalto, ha abierto nuevos caminos al introducir dopaje inducido por polarización en estructuras N-polares de AlGaN/AlN. Gracias a las polarizaciones espontáneas y piezoeléctricas, esta forma de dopaje puede aumentar la corriente y reducir la resistividad de los contactos. Utilizando dopaje inducido por polarización, hemos demostrado los primeros PolFET y HEMT N-polares basados en AlN con corrientes de drenaje superiores a 100 mA mm-1. Este éxito nos ha llevado a ver el AlN como un semiconductor práctico para dispositivos ópticos y eléctricos.
Para producir estos dispositivos hemos podido recurrir a varios proveedores de materiales. Se pueden comprar muestras de AlN de alta calidad sobre sustratos de zafiro de 2 pulgadas en Dowa Electronics Materials, y AlN a granel de 2 pulgadas está disponible comercialmente en Stanley y Asahi Kasei.

Figura 3. (a) Perfiles de profundidad de la concentración de impurezas de silicio, oxígeno y carbono en una capa de AlN implantada con silicio de 3 µm de espesor después del recocido a 1600 °C. ( b ) Perfiles de profundidad de la concentración de magnesio en una capa de AlN implantada con magnesio de 1 µm de espesor después del recocido.
Dopaje AlN
El control de la concentración de dopantes en los semiconductores es la incorporación de impurezas durante el crecimiento del cristal, así como la difusión térmica y posiblemente la implantación. Esta última es una tecnología atractiva que permite un control preciso de la dosis y garantiza una alta uniformidad lateral del dopante. Sin embargo, cuando se emplean implantaciones de dosis altas, tienden a dañar las redes cristalinas e introducir altas concentraciones de defectos puntuales, que pueden compensar a los portadores. Afortunadamente, la mayor parte de este daño se puede reparar con recocido postérmico, que hemos utilizado al producir un canal de AlN tipo n implantado con silicio.
Una de las características impresionantes de los cristales de AlN, incluidas sus superficies, es su robustez a temperaturas elevadas, con estabilidad bajo nitrógeno gaseoso hasta 1700 °C. Esta robustez proporciona una amplia ventana para reparar el daño de la implantación; este proceso requiere temperaturas superiores a 1200 °C para la activación eléctrica de la capa de AlN implantada con silicio. Sin embargo, tenga en cuenta que es necesario pensar mucho al seleccionar la temperatura de recocido, ya que puede provocar otros cambios en el material. Más allá de los 1400 °C, las impurezas de silicio y oxígeno se difunden dentro de la capa superior. Debido a la difusión de átomos de oxígeno del sustrato de zafiro, que se descompone a 1500 °C bajo gas nitrógeno, una fina capa de AlN sobre un sustrato de zafiro tendrá una alta concentración de oxígeno después del recocido a alta temperatura, lo que provocará características eléctricas degradadas.
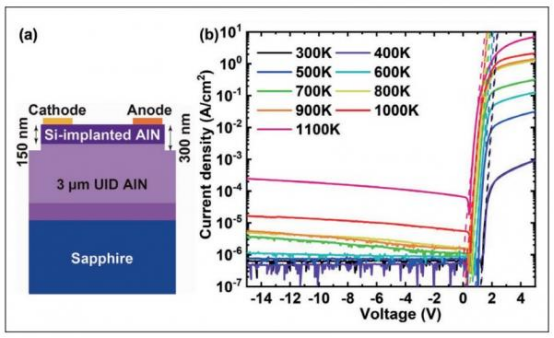
Figura 4. (a) Sección transversal de un diodo de barrera Schottky con un canal de AlN implantado con silicio. Ánodo de Ni/Au y cátodo de Ti/Al/Ti/Au. (b) Características de densidad de corriente-voltaje de un diodo de barrera Schottky de AlN de 27 °C a 827 °C.
A través de la colaboración con el MIT, la Universidad Aalto, TNSC y Dowa Electronics Materials, hemos investigado la difusión de átomos de silicio, oxígeno y magnesio en AlN (ver Figura 3). Nuestras investigaciones revelaron que los átomos de oxígeno que se difunden desde un sustrato de zafiro no pueden alcanzar la capa del canal después del recocido mediante el uso de capas de AlN de 3 µm de espesor. Esto nos llevó a concluir que los rangos de temperatura de recocido preferidos para capas de AlN eléctricamente conductoras con implantes de silicio y magnesio son 1200-1600 °C y 1400-1500 °C, respectivamente. Este conocimiento nos permitió demostrar los primeros transistores de canal AlN.
Cuando la fabricación de dispositivos involucra condiciones cercanas al equilibrio térmico, como crecimiento epitaxial y recocido a alta temperatura, se favorece la formación de estados profundos con energías de ionización de 250-320 meV. Esto tiende a conducir a una autocompensación del donante de silicio, situación que concuerda con nuestros resultados.
Mientras tanto, el uso de procesos de no equilibrio, como la implantación de iones, permite un aumento en la población de donantes superficiales con energías de ionización de 64-86 meV. Esto llevó a Hayden Breckenridge y sus colegas de la Universidad de Carolina del Norte y Adroit Materials a producir una capa altamente conductora de AlN mediante implantación de silicio y recocido posterior a una temperatura relativamente baja de 1200 °C. Otro resultado alentador, procedente de la Universidad de Kyoto, es que la energía de unión sustitucional del aceptor de magnesio del AlN es de sólo 250-410 meV, un valor mucho menor que la energía de ionización de los aceptores de magnesio en las capas comunes de AlN cultivadas con MOCVD. En conjunto, estos resultados indican que si las condiciones del proceso de desequilibrio pueden controlarse de forma reproducible y sencilla en AlN dopado con silicio y magnesio, esto podría abrir la puerta a dispositivos electrónicos y ópticos con un rendimiento significativamente mejorado.
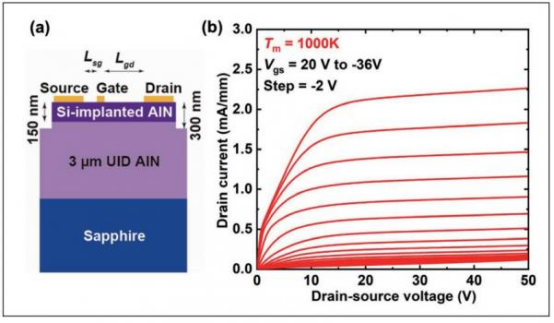
Figura 5. (a) Sección transversal esquemática de MESFET con un canal de AlN implantado con silicio. (b) Características de salida de CC de un MESFET de AlN a 727 °C.
Propiedades eléctricas del AlN
Para mejorar el rendimiento eléctrico de los dispositivos basados en AlN, hay más que hacer que simplemente abordar la alta resistividad de las capas de AlN de tipo n y p que se ven afectadas por bajas concentraciones de portadores. Además, es necesario abordar la alta resistividad de contacto, resultante de la pequeña afinidad electrónica.
Resulta particularmente complicado realizar un contacto óhmico a temperatura ambiente en AlN. La caída de voltaje está gobernada por la altura de la barrera Schottky, que depende de la diferencia entre la función del trabajo del metal y la afinidad electrónica del semiconductor. Es posible producir contactos óhmicos reduciendo la altura de la barrera de potencial mediante la selección adecuada de los materiales de los electrodos. Las opciones para AlN tipo n son titanio, aluminio, vanadio y molibdeno, mientras que los contactos óhmicos para AlN tipo p pueden usar paladio y NiO.
Una implicación del fuerte dopaje en materiales semiconductores es una disminución en el ancho de la región de agotamiento, lo que lleva a la creación de túneles a través de barreras potenciales. El fuerte dopado de la superficie superior de AlN es muy importante para los contactos óhmicos. Sin embargo, como la concentración de dopantes de silicio y magnesio en las capas de AlN está limitada a alrededor de 1019 centímetro-3, quizás debido a la formación de defectos de compensación, no hay perspectivas de construcción de túneles con emisiones de campo.
Para determinar la concentración y la movilidad de los portadores en estructuras semiconductoras, los investigadores tienden a recurrir a mediciones del efecto Hall. Como estas mediciones necesitan un comportamiento óhmico, algunos estudios han utilizado capas de contacto de GaN fuertemente dopadas. Esto permitió determinar las propiedades eléctricas del AlN, tanto a temperatura ambiente como a temperaturas elevadas. Junto con otros, hemos evaluado la concentración y movilidad de los portadores a altas temperaturas, obteniendo valores para AlN tipo n y tipo p a temperaturas superiores a 200 °C y 500 °C, respectivamente.
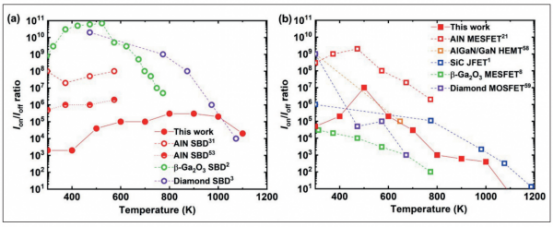
Figura 6. Un gráfico de evaluación comparativa que compara la relación de encendido y apagado actual versus la temperatura de medición de los dispositivos de AlN con los otros diodos de barrera Schottky de última generación (a) y (b) FET.
Al realizar este estudio, descubrimos un nuevo problema asociado con las mediciones de alta temperatura. Tuvimos que utilizar una estación de sonda, ya que carecíamos de tecnologías de unión y empaquetado para temperaturas extremas. También descubrimos que las puntas de las sondas normales se deterioran a altas temperaturas. Tenga en cuenta que la mayoría de los dispositivos reportados tienen una temperatura máxima de funcionamiento de no más de 500 °C, lo que implica que las mediciones de propiedades eléctricas no son confiables a temperaturas superiores a esta.
Trabajando con Dowa Electronics Materials, hemos evaluado las características eléctricas de capas de AlN de 3 µm de espesor sobre sustratos de zafiro con un sistema de sonda de alta temperatura que ofrece una temperatura de medición máxima de 900 °C en alto vacío. Para este esfuerzo implantamos silicio en la capa de AlN a temperatura ambiente para obtener conductancia tipo n; la concentración fue 2 × 1019 centímetro-3 en un perfil de caja de 150 nm de profundidad. Estas capas de AlN implantadas con silicio se recocieron posteriormente a 1500 °C. Luego depositamos electrodos de Ti/Al/Ti/Au para contactos óhmicos, antes de sinterizar a 950 °C.
Nuestros electrodos se deterioraron a 877 °C, posiblemente debido a una reacción entre Ti/Al y AlN. Esto nos llevó a buscar metales adecuados para contactos óhmicos a temperaturas extremas. Para las temperaturas que pudimos considerar, observamos una relación corriente-voltaje que no es lineal por debajo de 127 °C y casi lineal por encima de 227 °C. La evaluación de las propiedades eléctricas entre 227 °C y 827 °C reveló que la resistencia de la lámina y la resistividad de contacto disminuían al aumentar la temperatura. De 227 °C a 627 °C, a medida que la temperatura aumentaba, la movilidad de los electrones disminuyó ligeramente, pero la concentración de electrones aumentó debido a una mayor ionización del donante, lo que resultó en una reducción en la resistencia de la lámina a altas temperaturas. Esto nos llevó a concluir que las capas de AlN tipo n exhiben un excelente rendimiento a temperaturas extremas.
Diodos y transistores
Hemos fabricado diodos de barrera Schottky y MESFET con capas de AlN implantadas con silicio sobre sustratos de zafiro. Nuestros diodos son capaces de operar a 827 °C (ver Figura 4), superando todos los récords anteriores, mientras que nuestros transistores pueden operar hasta 727 °C (ver Figura 5). Los diodos de barrera Schottky de AlN tienen un voltaje de ruptura de 610 V a temperatura ambiente, mientras que el valor correspondiente a los MESFET de AlN a 727 °C es de 176 V. Queremos señalar que estos dispositivos son prácticamente factibles, porque tienen una sencilla estructura, y las capas de AlN se cultivan en sustratos de zafiro grandes y de bajo costo.
Para fabricar nuestros diodos de barrera Schottky y MESFET, utilizamos Ni/Au para los contactos del ánodo y de la puerta. Descubrimos que el níquel es térmicamente estable y apenas reacciona con el AlN, incluso a 827 °C. Es más, en términos de características eléctricas, encontramos poca diferencia entre Ni/Au y Pt/Au. Para el diodo de barrera Schottky, la corriente de corte es pequeña, incluso a 827 °C, debido a la baja concentración de portador intrínseco y la interfaz Ni/AlN térmicamente estable. Sin embargo, la corriente de drenaje fuera de estado del AlN MESFET es alta a 727 °C, debido a la fuga a través de las capas inferiores de AlN sin dopar y a la alta concentración de defectos. A diferencia de la corriente en los dispositivos de silicio, que cae a altas temperaturas debido a la dispersión de fonones, descubrimos que la corriente directa de los diodos de barrera Schottky de AlN y los MESFET continúa aumentando con la temperatura hasta 827 °C. Atribuimos esto a que la corriente en los dispositivos de AlN a temperaturas extremas está dominada por el aumento de la concentración de electrones y la reducción de la resistividad de contacto, mientras que la reducción de la movilidad de los electrones juega un papel secundario.
Nuestro desarrollo de dispositivos AlN está allanando una nueva forma de fabricar dispositivos semiconductores que puedan funcionar a temperaturas extremas. Aunque existe un equilibrio entre la relación de encendido y apagado y la temperatura de los diodos de barrera Schottky y los FET (consulte la Figura 6), los dispositivos de AlN tienen mucho potencial de mejora. Por ejemplo, debería ser posible aumentar la relación encendido/apagado a temperaturas extremas mediante una combinación de crecimiento homoepitaxial y la introducción de una estructura JFET. Se podrían obtener mejoras adicionales con la introducción de contactos óhmicos tolerantes al calor, en lugar de Ti/Al/Ti/Au, una medida que aumentaría la temperatura de funcionamiento a más de 877 °C.
Para la mayoría de las aplicaciones de temperaturas extremas, los circuitos integrados deben funcionar de manera confiable durante períodos prolongados. Estos circuitos se fabrican con tecnología complementaria, con canales n y p. En la Universidad de Kyoto, los ingenieros han desarrollado una puerta lógica JFET complementaria de SiC que funciona a 350 °C. Esperamos llevar nuestro trabajo en una dirección similar, produciendo JFET complementarios con canales de AlN homoepitaxiales que sean capaces de operar en ambientes extremos.
POR HIRONORI OKUMURA DE LA UNIVERSIDAD DE TSUKUBA
de https://compoundsemiconductor.net/article/118570/Extreme-temperature_devices_using_AlN
Por qué necesita nuestros servicios, sabe que está obteniendo profesionales altamente calificados que tienen la experiencia y los conocimientos para asegurarse de que su proyecto se realice correctamente y funcione.
si desea una consulta gratuita, comience bg completando el formulario:
Reciba información de ventas, noticias y actualizaciones en su bandeja de entrada.
 闽ICP备19012761号-1
闽ICP备19012761号-1



